淀积工艺简介:
薄膜淀积是微机械加工的重要手段,根据淀积方式的不同可分为化学气相沉积、溅射和电子束蒸发等,在基底表面形成各种介质膜和金属膜等,可用作掩蔽层、牺牲层、绝缘层、电极等。
处理材料:
直径为100mm的硅片、玻璃片以及SOI,厚度 范围400~1500um。
1、等离子体增强化学气相沉积台
设备说明:
英国牛津仪器公司的等离子体增强化学气相沉积台是研发的一种高性能、智能化操作界面的化学气相沉积设备。可通过不同工艺气体间的化学反应在样品表面沉积均匀性好、应力低的氧化硅(SiO2)、氮化硅(SiNx)薄膜。顶电极采用喷淋头式进气方式大大提高了沉积薄膜的均匀性,通过高频(13.56MHz)和低频(100KHz)两个射频源的交替起辉可有效降低沉积薄膜的应力。

技术指标:
沉积样品尺寸:φ240 mm (2 inch×9, 3 inch×4, 4 inch×1, 6 inch×1, 8 inch×1)
沉积温度 :300℃(室温~400℃)
沉积薄膜类型: SiO2、SiNx
沉积薄膜极限厚度:SiO2、SiNx≤5μm
薄膜均匀性:SiO2、SiNx:<±2%(4 inch)
薄膜应力 :SiO2:<300MPa 压应力; SiNx:<50MPa 张应力
击穿电压 :>5MV/cm(SiO2、SiNx)
2、薄膜沉积系统
设备简介:
美国Kurt J. Lesker公司的薄膜沉积系统,使用专用软件及带有触摸屏监视器的嵌入式计算机。设备配置2个射频电源和3个直流电源,同时配置4个3英寸磁控溅射靶源,其中2个靶源为强磁靶源可溅射磁性材料,如Fe、Ni;另外2个普通靶源可溅射普通金属材料以及非金属材料,如:Pt、Au、Ti、Cu、Al、Ag、Cr、SiO2等。

主要参数:
腔体尺寸:直径18英寸,高度20英寸
样品规格:最大直径6英寸
膜厚均匀性:±5%
基片盘转速:0~20r/min
3、真空镀膜机
设备说明:
河南中光学集团真空技术有限公司研发的光学真空镀膜机是一种高性能真空镀膜设备,主要应用于光学工业、半导体及微纳加工领域的光学薄膜及金属薄膜的蒸镀工艺。主要可以通过阻蒸蒸发和电子束蒸发梁总加热靶材的方式使表面组份以原子团或离子形式被蒸发,并沉积在基片表面,以实现蒸镀厚度不等的金属及光学薄膜,均匀性和重复性较好。

技术指标:
工件尺寸 :≤ 6 inch
极限压力 :2.0 × 10-3Pa
蒸 发 源 :电子枪束流 + 阻蒸蒸发
膜厚均匀性 :金属Al膜为±5%,金属Cu膜为±10%
4、国产溅射仪
设备简介:
中国科学院微电子中心研制的溅射仪,配置1个射频电源及3个靶源,可以沉积多种金属薄膜,例如:Pt、Ti、Cu、Al、Cr及多元合金等。设备的样品台为环形转盘,设有8个样品位置,可实现单片定点或多片旋转溅射以及2种材料在1个样片上交替溅射。
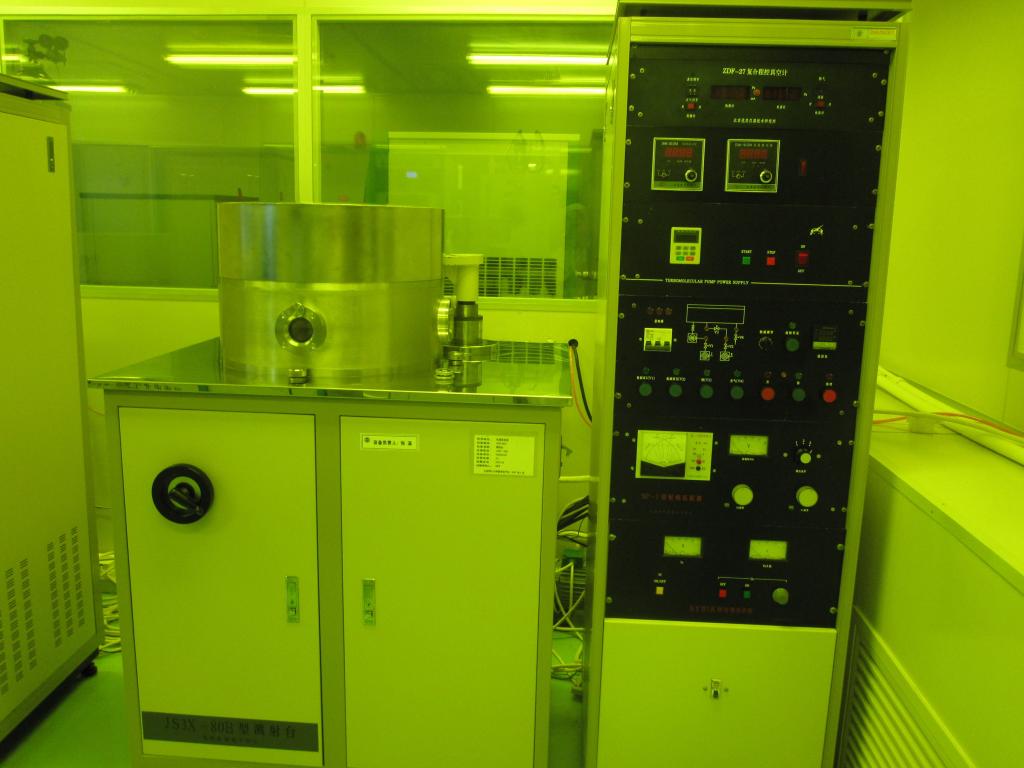
主要参数:
样品规格:最大3英寸;
极限真空度:4×10-4Pa;
样品台转速:0~20r/min;
真空室规格:直径520mm,高度200mm
5、离子溅射仪
设备简介:
日本电子公司的离子溅射仪,由主机和旋转泵系统组成,通过在样品表面溅射一层Au或Pt薄膜增加其导电性,为电镜配套设备。

主要参数:
溅射电流:10、20、30、40mA
样品台尺寸:直径64mm
靶材:Au、Pt
6、Parylene真空沉积系统
设备简介:
美国SCS公司的Parylene真空沉积系统,通过蒸发使固体原料变为气态,进入裂解室后通过高温裂解,变为单体,进入沉积腔后分子重新聚合,形成聚合物薄膜。该薄膜在表面贴装、微电子半导体、混合电路、传感器、医用仪器等领域有广泛应用。

主要参数:
蒸发室温度:室温至180℃
裂解室温度:室温至750℃
机械制冷器:-90℃






